Актуально для полупроводниковой промышленности, исследования тонких пленок, анализа напряжений / деформаций
Отжиг радиационных повреждений в пленке GaN с имплантацией Mg исследуется методом рентгеновской дифракции in situ. Поведение пленок при повышенных температурах сравнивается с поведением пленок GaN без имплантации, чтобы выявить влияние радиационного повреждения и момент, когда повреждение устраняется.
1 Введение
Нитрид галлия вызывает значительный интерес благодаря своему потенциалу в качестве источника синего и ультрафиолетового света, а также основного материала для применения в проводниках высокой мощности при высоких температурах (1).
При изготовлении устройств на основе GaN ионная имплантация представляет собой очень мощный инструмент с возможностью контролируемого и воспроизводимого изменения физических свойств полупроводника (2). Успешное применение этого метода зависит, однако, также от понимания процесса получения и отжига радиационных повреждений (2).
До настоящего времени в многочисленных работах и обзорах литературы рассматривались различные аспекты ионной имплантации в GaN (2-4).
Однако в большинстве исследований влияние отжига радиационных повреждений на свойства имплантированного GaN изучалось ex-situ без возможности отслеживать температурное изменение свойств материала в зависимости от изменения температуры отжига.
В этой работе рентгеновская дифракция (XRD) используется для характеристики температурного изменения параметров ненапряженной решетки и остаточных напряжений в тонких пленках GaN, имплантированных Mg, в диапазоне температур от 25 до 700 °C. Основная цель состоит в том, чтобы сравнить структурное поведение первичных и имплантированных тонких пленок GaN и понять влияние отжига радиационных повреждений на кристаллическую структуру.
2 Условия проведения эксперимента
Монохроматизированное излучение Cu-Ka использовалось для измерений полюсной фигуры и θ/2θ для характеристики структурных свойств тонких пленок GaN.
Высокотемпературные исследования методом рентгеновской дифракции в атмосфере азота проводились с использованием DHS 1100.
3 Платформа с нагревом DHS 1100
DHS 1100 Anton Paar - это первая платформа с нагревом для четырехкружных гониометров, позволяющая проводить температурно-зависимые рентгеновские исследования на Эйлеровых люльках. DHS 1100 можно установить на все распространенные четырехкружные гониометры вместо стандартного держателя образца. Исследования могут проводиться при температуре от комнатной до 900 °C. Благодаря рентгенопрозрачному куполу образцы можно исследовать в вакууме, воздухе или инертном газе, чтобы избежать окисления или другой химической реакции при высоких температурах.
4 Подготовка образцов
Гетероэпитаксиальная тонкая пленка GaN толщиной 1,5 мкм была выращена на Al2O3(0001) при 1060 °C с использованием металлоорганической парофазной эпитаксии стандартным способом осаждения. Затем образец был разбит на три части, и две из них были имплантированы при комнатной температуре ионами Mg различных энергий для получения почти однородной концентрации акцептора и профиля радиационного повреждения вплоть до границы раздела "сапфир". Соответствующие дозы были выбраны таким образом, чтобы получить максимальную концентрацию около 2 × 1019 мг/см3 в каждом максимуме имплантации и среднюю концентрацию 1,3 × 1019 мг/см3 по всему слою GaN (5). Один из двух имплантированных образцов затем подвергали отжигу в течение 15 с при 1150 °C в проточной среде N2 в печи быстрого термического отжига (RTA).
Три образца, представленные в этом отчете, а именно первичный (не имплантированный), Mg-имплантированный и RTA Mg-имплантированный, будут обозначены в тексте как A, B и C соответственно. Образцы А и В анализировали при повышенной температуре, в то время как образец С исследовали только при комнатной температуре после процедуры RTA.
5 Результаты и обсуждение
Высокое кристаллографическое качество тонких пленок с типичным гетероэпитаксиальным соотношением GaN(0001)[ 2̅ 110]||Al2O3(0001)[10 1̅ 0] было подтверждено измерениями полюсной фигуры.
Чтобы оценить параметры решетки и деформации в образцах, периоды решетки были определены с помощью измерений θ/2θ. Почти однородная концентрация акцептора и профили радиационного повреждения в имплантированном GaN позволили извлечь репрезентативное среднее по объему значение периода решетки из каждого дифракционного пика (при каждой конкретной температуре) (2).
Измерения дифракции проводились путем сканирования GaN-отражений (а именно 00.2, 00.6, 10.5, 10.6, 20.4, 20.5, 21.2, 21.3 и 21.4) в температурном цикле, начинающемся при комнатной температуре (25 °C), с нагревом до максимальной температуры, а затем охлаждением снова до комнатной температуры с шагом 50 °C. При каждой температуре измерения образцы анализировались в течение примерно 15 минут. Во время процедуры отжига наблюдалось значительное смещение дифракционных пиков из-за отжига радиационных повреждений и теплового расширения решетки GaN, см. рисунок 1.
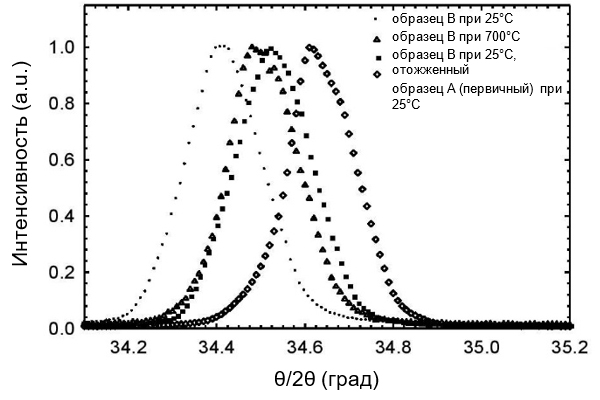
Рисунок 1. Дифракционные снимки отражений GaN 002, измеренные для имплантированного образца (B) до отжига (круги), во время отжига при 700 °C (треугольники) и после отжига (квадраты). Для сравнения представлены данные из первичного образца (А) (ромбы).
Результаты измерений периода решетки были использованы для расчета напряжений и параметров ненапряженной решетки в тонких пленках с использованием подхода, описанного ранее (6,8,10).
Усредненные по объему зависящие от температуры напряжения в плоскости σТ и параметры ненапряженной решетки в плоскости αТ были уточнены одновременно по данным дифракции с использованием зависящих от температуры тензорных соответствий SТijkl монокристаллов гексагонального GaN и соотношений для параметров ненапряженной решетки (c0/α0)T, принятых из (11) и (12), соответственно. Значения напряжений и параметров ненапряженной решетки были определены с максимальными стандартными погрешностями ±30 МПа и ±40 fm соответственно.
На рисунке 2 представлена температурная зависимость параметра ненапряженной решетки в плоскости a (αT) в гексагональном GaN для образцов A и B.
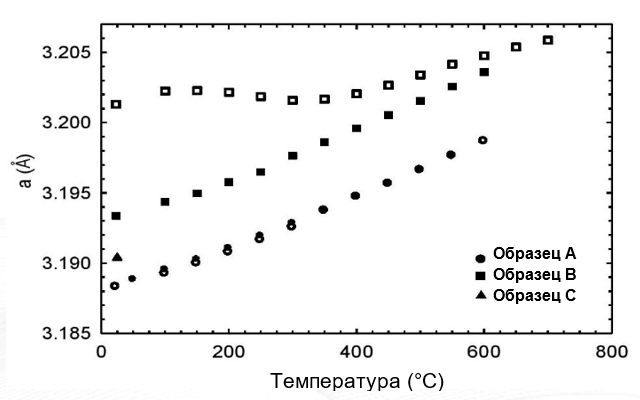
Рисунок 2. Температурная зависимость параметра ненапряженной решетки в плоскости a (α T). Пустые и заполненные символы представляют цикл нагрева и охлаждения соответственно.
В случае первичного образца (А) данные демонстрируют ожидаемые обратимые изменения величины параметра решетки из-за теплового расширения GaN без какого-либо значительного гистерезиса. Однако для образца В наблюдается интересный температурный гистерезис в поведении αТ. Во время процедуры нагрева параметр решетки сначала увеличивается примерно до 100 °C в соответствии с поведением первичного образца (А).
Однако выше 100 °C наклон δαT/δТ в имплантированном образце систематически меньше по сравнению с поведением первичной структуры, в то время как в диапазоне температур примерно от 100 до 300 °C наклон δαT/δТ, а также коэффициент теплового расширения (TEC) αТα даже отрицательны. Во время процедуры охлаждения в образце В наклон δαT/δТ, что интересно, идентичен наклону δαT/δТ, наблюдаемому для первичного образца. На рисунке 2 также представлено значение параметра решетки a, наблюдаемое в образце C после процедуры RTA. Это значение находится между значениями, наблюдаемыми для образцов А и В (после нагрева), и логически подтверждает, что с повышением температуры отжига возможно более интенсивное устранение радиационного повреждения.
Специфический температурный гистерезис в поведении αT в имплантированном GaN (образец B, рис. 2) может быть интерпретирован как активируемое температурой исправление дефектов в кристалле. До 100 °C устранение радиационного повреждения происходит не очень интенсивно, в то время как в диапазоне температур около 100-300 °C происходит значительное исправление дефектов. При дальнейшем повышении температуры (выше 300 °C) устранение повреждений продолжается, но не так интенсивно. Такое поведение может указывать на то, что различные типы дефектов устраняются при разных температурах отжига.
Температурное изменение усредненных по объему напряжений в плоскости тонкой пленки GaN (αT) для образцов A и B представлено на рисунке 3.
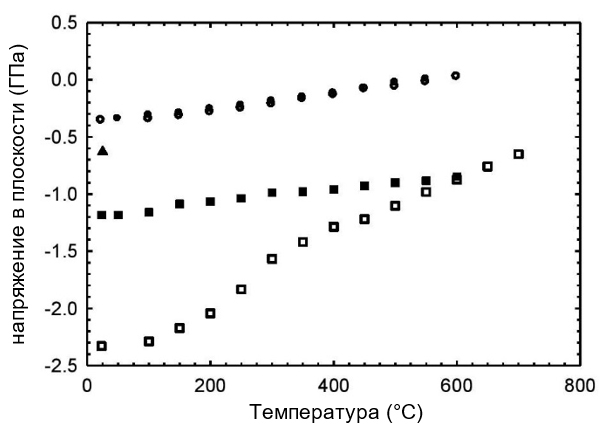
Рисунок 3. Температурная зависимость плоскостных напряжений αT. Пустые и заполненные символы представляют цикл нагрева и охлаждения соответственно.
Развитие напряжений в первичном образце (А) является обратимым (без гистерезиса) (6). В образце В повышение температуры приводит к значительному уменьшению напряжения в плоскости. Для процедуры охлаждения наклон сопоставим с наклоном, наблюдаемым для образца A. Аналогично тому, как в случае зависимости параметров решетки (рис. 2), значение напряжения в плоскости (α RT) при комнатной температуре в образце C находится между значениями образцов A и B (рис. 3).
Полученные данные указывают на то, что Mg-имплантация индуцировала значительное расширение кристаллической решетки GaN. Как в плоскости (a), так и вне плоскости (c) параметры решетки гексагонального GaN были расширены в имплантированной структуре и, одновременно, отношение (с/α)T увеличилось. Увеличение отношения (с/α)T было связано с увеличением напряжения сжатия в плоскости в монокристаллической структуре по сравнению с (с0/α0)T для параметров ненапряженной решетки (12).
В случае первичного образца температурная зависимость напряжений σT может быть объяснена несоответствием TEC в плоскости между слоем (индуцирующим σTextrinsic ) и подложкой, что дает возможность экстраполировать внутреннее напряжение σTintrinsic в первичной тонкой пленке GaN (6).
В имплантированный образец вводится новая составляющая напряжения, и, таким образом, общее напряжение σT в имплантированном образце может быть записано как σT = σintrinsic + σTextrinsic + σTimplanted, в то время как только σTextrinsic и σTimplanted зависят от температуры.
Этот подход позволяет количественно оценить напряжение σTimplanted, вызванное имплантацией, по данным на рисунке 3.
Предполагая, что удельная (приблизительно линейная) зависимость параметра решетки в плоскости αT в диапазоне температур 350 - 700 °C во время цикла нагрева существенно не изменится при более высоких температурах (и принимая во внимание также значение αRT образца C), можно было бы экстраполировать температуру, которая была бы необходима для значительной минимизации радиационного повреждения в имплантированном образце (для достижения αTimplanted = αTvirgin). Сопоставление данных на рисунке 2 с линейной зависимостью дало значение около 1620 °C, что составляет примерно 2/3 от температуры плавления GaN (13).
6 Выводы
До сих пор влияние отжига радиационных повреждений на свойства имплантированного GaN изучалось только ex-situ.
С платформой с нагревом DHS 1100 для четырехкружных гониометров можно использовать рентгеновскую дифракцию для исследования тонких пленок GaN, имплантированных Mg, на сапфире (0001) при температуре от 25 ° C до 700 °C.
Температурные зависимости параметров ненапряженной решетки и напряжений указывают на то, что отжиг радиационных повреждений в GaN является процессом, зависящим от температуры, поскольку только во время процедуры нагрева наклоны δαT⁄δT и δαT⁄δT в имплантированной тонкой пленке GaN отличаются от наклонов первичного материала.
Основная часть радиационных повреждений была устранена при нагревании в диапазоне температур от 100°C до 300°C.
Предел в 1620 °C был оценен как важный температурный предел отжига для значительного уменьшения радиационного повреждения.
7 Референс
- S. C. Jain, M. Willander, J. Narayan, R. Van Overstraeten, J. Appl. Phys. 87 (2000) 965, and ref-erences therein.
- S. O. Kucheyev, J. S. Williams, S. J. Pearton, Mater., Sci. Eng. R 33 (2001) 51, and references therein.
- J. S. Williams, Mater. Sci. Eng. A 253 (1998) 8.
- S. J. Pearton, J. C. Zolper, R. J. Shul, F. Ren, J. Appl. Phys. 86 (1999) 1.
- A. Wenzel, Charakterisierung von ionenimplantier-tem Galliumnitrid, Thesis, Universität Augsburg, Mensch und Buch Verlag, Berlin (2002).
- J. Keckes, J. W. Gerlach, R. Averbeck, H. Rie-chert, S. Bader, B. Hahn, H.-J. Lugauer, A. Lell, V. Härle, A. Wenzel, B. Rauschenbach, Appl. Phys. Lett. 79 (2001) 4307.
- R. Resel, E. Tamas, B. Sonderegger, P. Hofbau-erand, J. Keckes, J. Appl. Cryst. 36 (2003) 80.
- J. Keckes, J. W. Gerlach, B. Rauschenbach, J. Cryst. Growth 219 (2000) 1.
- S. B. Qadri, B. Molnar, M. Yousuf, C. A. Carosel-la, Nucl. Instr. Meth. B 190 (2002) 878.
- J. Keckes, S. Six, W. Tesch, R. Resel, B. Rau-schenbach, J. Cryst. Growth 240 (2002) 80.
- R. R. Reeber and K Wang, MRS Internet J. Ni-tride Semicond. Res. 6 (2001) 3.
- R. R. Reeber and K. Wang, J. Mater. Res. 15 (2000) 40.
- J. A. Van Vechten, Phys. Rev. B. 7 (1973) 1479.
Данные предоставил:
Джозеф Кекес (Jozef Keckes)
Институт материаловедения имени Эриха Шмида Австрийской академии наук и Институт физики металлов Университета Леобена,
A-8700 Леобен, Австрия



